硅基低压MOSFET器件因其在多个高科技领域的应用而成为研究的焦点,尤其是在小电流驱动和电源控制模块等方面。这些器件的性能和可靠性很大程度上依赖于生产过程中的工艺质量。本文通过采用热点分析和聚焦离子束-扫描电子显微镜(FIB-SEM)技术,提出了一种高效的检测手段,用以快速识别和分析沟槽MOSFET器件在电学性能和膜层结构上的失效。下图是晶圆失效分析流程概述图。

硅基低压MOSFET的市场背景和重要性,然后详细介绍了器件的制造工艺,包括关键步骤如外延片的选用、低压化学气相沉积(LPCVD)、光刻、刻蚀、多晶硅层的沉积以及金属化过程。在失效分析方面,结合了I-V特性测试、电光微区扫描(EMMI)热点检测和FIB-SEM结构分析等技术手段,以识别和诊断器件失效的原因。
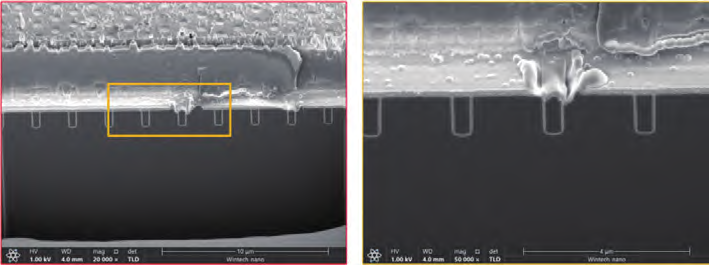
器件沟槽形貌异常剖面图
在对沟槽型MOSFET产品的实际测试中,观察到最小击穿电压达到60V,并利用I-V测试和EMMI技术精确定位了漏电失效点。FIB-SEM的形貌分析进一步揭示了沟槽结构的不均匀性,包括多晶硅层的不均匀分布和上部区域的凹槽现象。文章深入探讨了可能的工艺问题,指出了LPCVD多晶硅沉积过程中的异常、过量刻蚀的选择性和速率差异可能是导致失效的关键因素。
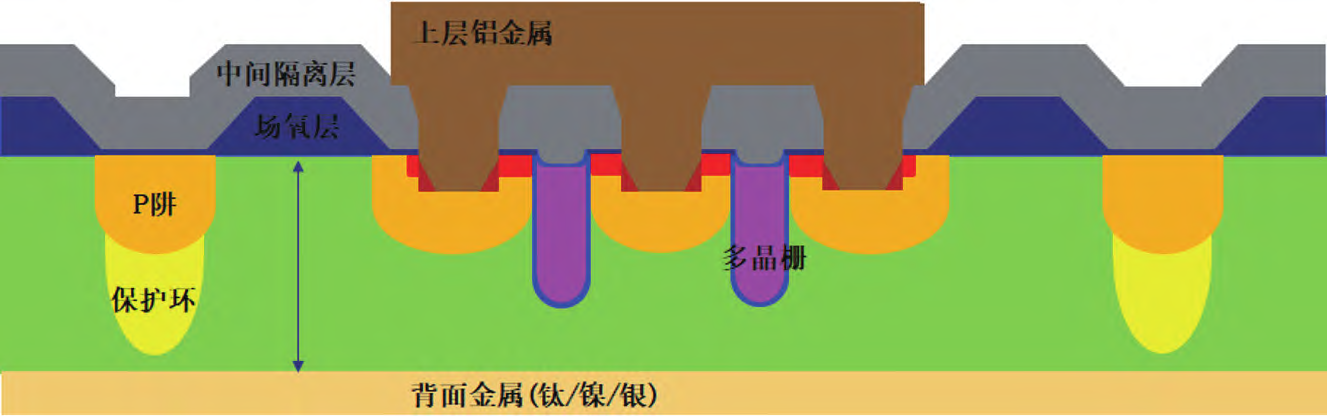
此结论强调了EMMI和FIB-SEM检测方法在快速诊断MOSFET器件多晶硅刻蚀异常方面的重要性,并为量产过程中的漏电失效问题提供了解决方案。此外,提出了在中试和量产阶段增加设备维护的建议,以提高工艺的稳定性和产品的可靠性。
总的来说,通过结合工艺流程和失效分析技术,为硅基低压MOSFET器件的失效分析和工艺改进提供了全面的技术支持和策略,有助于推动相关领域的技术进步和产品质量的提升。





发表评论 取消回复