在二维多孔Si/Al2O3/SiC薄膜材料的透射电镜截面微观结构表征中,存在一些挑战,如薄膜的脱落倾向、较大的脆性、较差的耐磨性,以及在选区制备过程中的难度大、制样效率低和成功率不高等问题。然而,通过采用聚焦离子束(FIB)技术,研究人员成功地对这类薄膜的截面微观形貌进行了高质量的表征。研究表明,FIB技术可以显著减少样品制备过程中的损伤,是一种有效的表征方法。
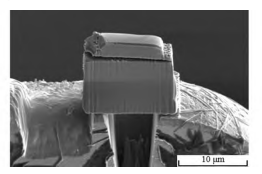
在实验过程中,研究人员首先使用扫描电镜选取合适的区域,然后对所选区域进行表面喷铂处理,以减少后续镓离子束轰击可能产生的损伤。样品台倾斜至52°,以便于离子束轰击所选位置两侧的样品,同时利用电子束进行成像,观察侧面结构。通过FIB技术,研究人员能够精确地制备出所需的截面样品,并通过透射电镜观察到薄膜的微观结构。
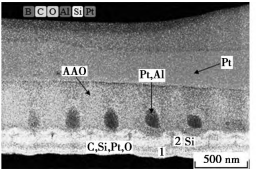
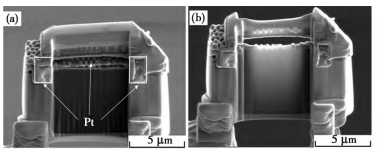
研究结果表明,通过改变薄膜制备条件,可以有效地控制薄膜的生长质量。例如,在沉积温度600℃、沉积时间10分钟的条件下,所制备的样品显示出更为紧密的多孔氧化铝模板与基底贴合,以及清晰可见的SiC层。通过元素扫描,研究人员能够确认样品中不同区域的化学成分,从而验证了二维多孔Si/Al2O3/SiC薄膜的成功制备。为了方便大家对材料进行深入的失效分析及研究,金鉴实验室具备Dual Beam FIB-SEM业务,包括透射电镜( TEM)样品制备,材料微观截面截取与观察、样品微观刻蚀与沉积以及材料三维成像及分析等。
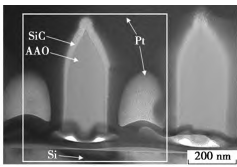
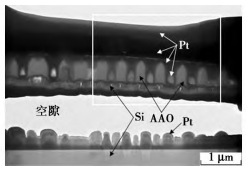
总结来说,FIB技术在二维多孔Si/Al2O3/SiC薄膜的透射电镜截面微观结构表征中发挥了重要作用,不仅提高了制样的成功率和效率,还有助于获得高质量的截面样品,为材料的微观结构分析提供了有力支持。
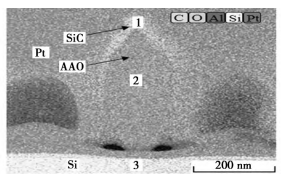
对于SiC材料应用、发展前景、高温电子学、高频器件、高功率器件、紫外探测器件等领域的研究背景,以及透射电镜(TEM)技术在材料科学中的应用情况。通过这些,我们能够更深入地了解SiC材料的特性和潜在应用,以及如何利用TEM技术来研究这些材料的微观结构。





发表评论 取消回复