聚焦离子束技术概述
聚焦离子束技术,简称FIB,是一种利用聚焦的离子束对材料表面进行微米至纳米级加工的技术。该技术通过电透镜系统将离子束精确聚焦,实现对材料的精确剥离、沉积、注入、切割和改性。随着纳米科技的快速发展,FIB技术已成为纳米尺度制造业中不可或缺的核心工艺。
FIB技术应用
FIB技术与高分辨率的扫描电子显微镜(SEM)等设备结合使用,为纳米级分析和制造提供了强大的工具。它广泛应用于微纳加工、离子注入、材料切割以及故障分析等领域,是解决微纳米级产品缺陷的关键技术。
FIB技术解决产品质量问题
1. 微纳米级缺陷分析:FIB技术能够精确地定位并切割产品表面的微小缺陷,如异物、腐蚀或氧化等,制备截面样品,并通过SEM观察缺陷与基材的界面情况。
2. 薄膜结构观察:对于经过表面处理形成的微米级薄膜样品,FIB技术可用于切割制样,以观察薄膜的结构和与基材的结合程度。
3. 样品制备注意事项:FIB技术对样品有一定的要求,包括样品尺寸、导电性、磁性等,以确保加工过程的顺利进行和设备的安全。为了方便大家对材料进行深入的失效分析
操作要点
样品尺寸应控制在5×5×1cm以内,对于过大的样品需要进行切割取样。
样品需要具备导电性,不导电的样品应通过喷金等方式增加导电性。
样品不得带有磁性,以避免对设备造成干扰。
对于颗粒样品,在进入设备前应检查其制备情况,确保符合标准,防止设备损伤。
切割深度建议控制在50微米以内,以保证样品的完整性和加工的精确性。
FIB技术应用实例
1. 微米级缺陷样品截面制备:利用FIB技术制备微米级缺陷样品的截面,为进一步的分析提供基础。
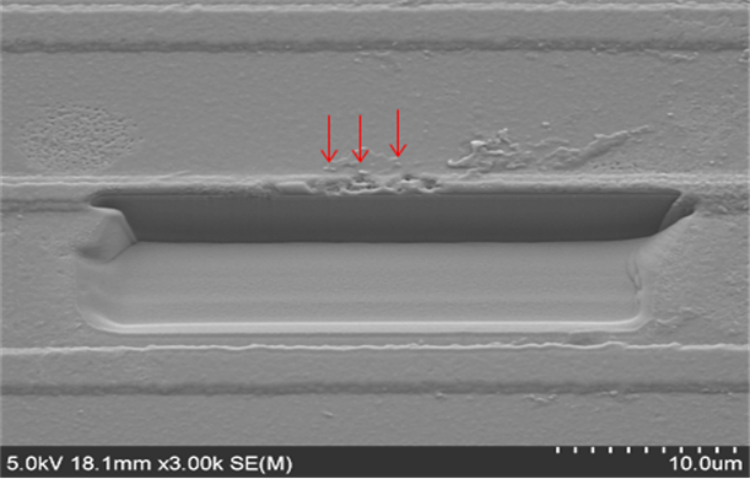
2. PCB电路分析:在PCB电路断裂位置,FIB技术结合离子成像技术,可以观察铜箔的金相结构,为故障分析提供重要信息。






发表评论 取消回复