在半导体故障失效分析的过程中,光发射显微镜(EMMI)是一种关键的故障点定位工具。这种设备通过检测电子-空穴复合和热载流子释放的光子,帮助识别半导体元件中的缺陷。传统的EMMI设备使用冷却式电荷耦合元件(C-CCD)传感器,能够探测400nm至1100nm波长的光子,覆盖了可见光和部分红外光的光谱。
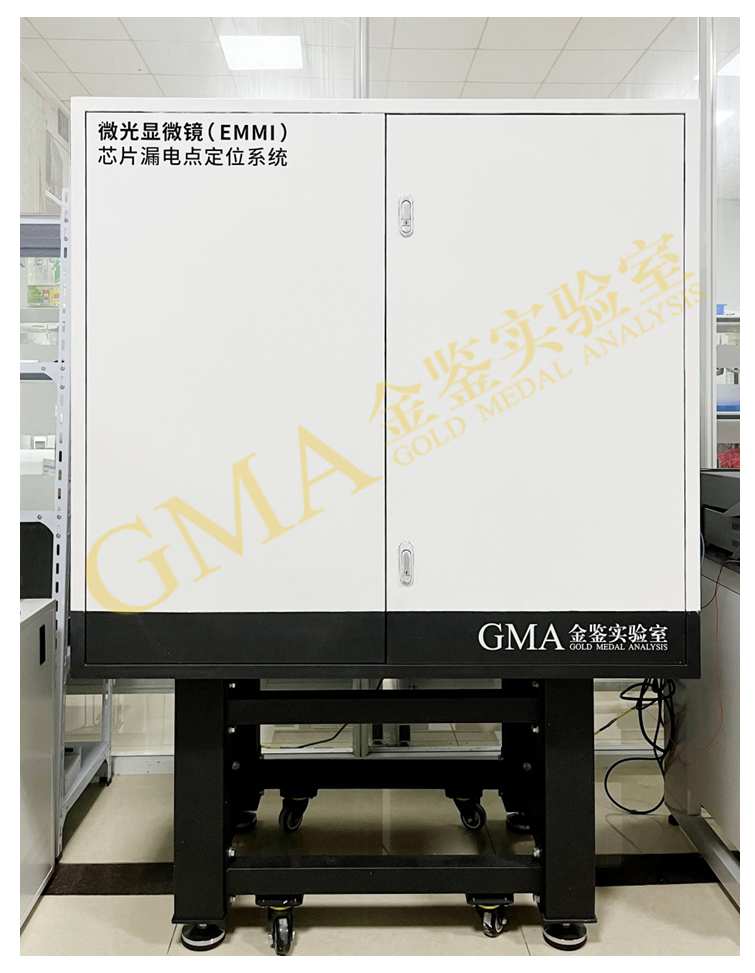
仪器特点:
①InGaAs采集相机,在近红外区域具备高灵敏度;
②分辨率高;
③多倍率图像采集:5X~100X;
④超低温电制冷降低暗电流带来的信噪;
⑤电制冷/空气冷却自由转换。
应用范围:
①LED故障分析
②太阳能电池评估
③半导体失效分析
④EL/PL图像采集
⑤光通信设备分析
检测到亮点的情况:
引起热点的缺陷:会产生亮点的缺陷-漏电结;接触毛刺;热电子效应;闩锁效应;氧化层漏电;多晶硅晶须;衬底损伤;物理损伤等。
原本存在的亮点:饱和/有源双极晶体管、饱和MOS/动态CMOS、正向偏置二极管/反向偏置二极管(击穿)。
无法检测到亮点的情况:
无光点的缺陷、欧姆接触、金属互联短路、表面反型层和硅导电通路等。
四案例分析
1、客户送样漏电LED蓝光芯片,通过InGaAs EMMI测试在芯片正极电极位置检测到异常点。

2、客户送样漏电LED蓝光倒装芯片,通过InGaAs EMMI测试在芯片位置可检测到异常点,并观察到击穿形貌。
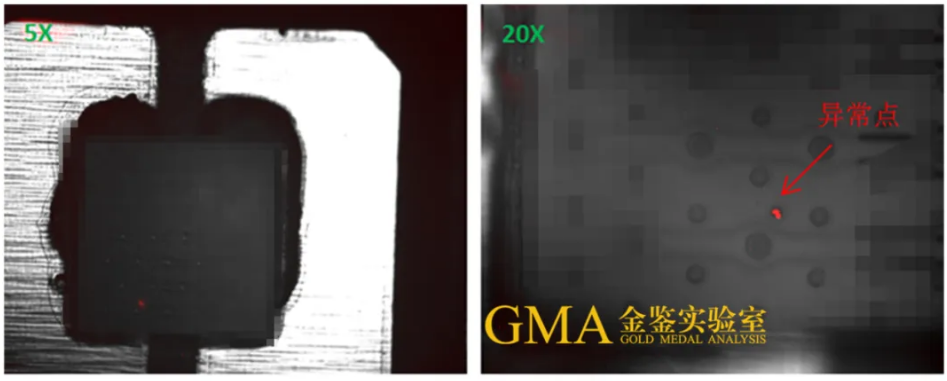
3、客户送样漏电LED红光垂直芯片,通过InGaAs EMMI测试在芯片位置可检测到异常点。

4、客户送样硅基芯片,通过InGaAs EMMI测试在芯片位置可检测到异常点。






发表评论 取消回复